膜加工・エッチング
Film Processing and Etching
機能デバイスの製造工程では、試料表面、例えば薄膜表面に塗布したレジスト膜に露光・現像してできたマスクパターンを用いて試料表面をエッチング(食刻)することで、薄層のパターンを形成する。その後、不要となったマスク(レジスト)を除去する(アッシング)。なお、微細加工をマスクを使わず直接行う手法もある。集束イオンビーム加工やレーザー加工である。
In the manufacturing process of functional devices, a thin layer pattern is formed by etching the sample surface using a mask pattern created by exposing and developing a resist film applied to the sample surface, for example, a thin film surface. Afterwards, the mask (resist) is removed (ashing) when it is no longer needed. There are also methods to perform microfabrication directly without using a mask. These are focused ion beam processing and laser processing.
ドライエッチング(RIE)
Dry Etching(RIE)
ドライエッチングの一つである反応性イオンエッチング(Reactive Ion Etching: RIE)は、反応室内でエッチングガスに電磁波などを与えプラズマ化し、同時に試料を置く陰極に高周波電圧を印加する。これにより試料とプラズマの間に生じた自己バイアス電位により、プラズマ中のイオン種やラジカル種が試料方向に加速されて衝突する。その際、イオンによるスパッタリングと、エッチングガスの化学反応が同時に起こり、微細加工に適した高い精度でのエッチングが行える。
In reactive ion etching (RIE), one of the dry etching methods, electromagnetic waves are applied to the etching gas in the reaction chamber to create plasma, and at the same time, a high-frequency voltage is applied to the cathode where the sample is placed. At the same time, a high-frequency voltage is applied to the cathode where the sample is placed. Due to the self-bias potential created between the sample and the plasma, ions and radicals in the plasma are accelerated in the direction of the sample and collide with each other. In this process, sputtering by the ions and chemical reaction of the etching gas occur simultaneously, and etching with high precision suitable for microfabrication can be performed.
汎用ICPエッチング装置
General purpose ICP etching machine

【English】ICP-RIE ULVAC CE-300I
【別名】CE-300 ICP-RIE
【型式番号】ULVAC CE-300I
【apparatus ID】125
【機器ID】F-UT-104
【機能】誘導性結合プラズマ(ICP)エッチング装置で、こちらは汎用装置です。
4”丸型ウエーハの入る装置です。
利用可能ガスは、アルゴン、SF6、CF4、CHF3、O2です。
主に酸化膜のエッチングや、イオンミリングによる金属のエッチングに利用しています。
【Alias】
【Model Number】ULVAC CE-300I
【Apparatus ID】125
【Equipment ID】F-UT-104
【Specifications】Wafer size: 4''. Gas: Ar, SF6、CF4、CHF3、O2. Used mainly for Si, SiO2 etching and metal etching by Ar milling.
高速シリコン深掘りエッチング装置
Ultra Rapid Silicon Deep Reactive Ion Etching Machine
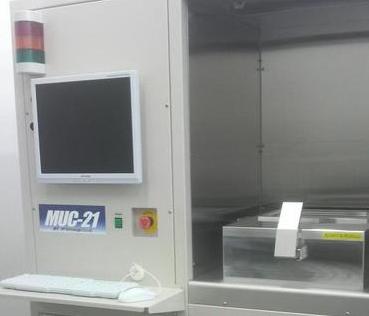
【English】Ultra Rapid Silicon Deep Reactive Ion Etching Machine
【別名】MUC21-ASE Pegasus エッチング装置
【型式番号】SPTS MUC-21 ASE-Pegasus
【apparatus ID】136
【機器ID】F-UT-116
【機能】高密度プラズマにより(ICPパワー3kWまで。1800W常用)、低ダメージ、高速にてエッチングが可能です。(例:当方のEBレジストを用い、scalloping100nm程度で100μm開口トレンチ20分エッチングで135μm)4”装置
100nmクラス開口特殊レシピ有。また、SF6による「ドライリリース」や、C4F8による酸化膜エッチングなど、組み合わせで便利に使えるレシピも利用できます。
【Alias】
【Model Number】SPTS MUC-21 ASE-Pegasus
【Apparatus ID】136
【Equipment ID】F-UT-116
【Specifications】Thanks to high density plasma (max ICP power is 3kW, usual power 1.8kW), low damage fast etching is possible. Sample size: 4''.
塩素系ICPエッチング装置
ICP-RIE machine

【English】ICP-RIE machine
【別名】CE-S ICP-RIE装置
【型式番号】ULVAC CE-S
【apparatus ID】129
【機器ID】F-UT-117
【機能】オペレーションの容易さで評判のCE-300Iの後継機
8”装置(任意サンプル貼り付けエッチング可能)
Cl2, BCl3, SF6, CHF3, Ar, O2によるエッチングが可能ですが、主に使い分けとしてCl系のエッチングを行っています。
【Alias】
【Model Number】ULVAC CE-S
【Apparatus ID】129
【Equipment ID】F-UT-117
【Specifications】Easy to use as its predecessor CE-300I, but can handle 8'' wafers. Gas: Cl2, BCl3, SF6, CHF3, Ar, O2. Mainly used for Cl based gas etching.
汎用高品位ICPエッチング装置
ICP-RIE machine

【English】ICP-RIE machine
【別名】NE-550 ICP-RIE装置
【型式番号】ULVAC NE-550
【apparatus ID】134
【機器ID】F-UT-123
【機能】CE-300Iの上位機種(ULVACのフラッグシップモデル)です。
大津・八井研究室の協力により利用可能になりました。
4”装置 塩素・フッ素系汎用
Cl2, BCL3, Ar, O2, CF4,CHF3, SF6, C3F8
【Alias】
【Model Number】ULVAC NE-550
【Apparatus ID】134
【Equipment ID】F-UT-123
【Specifications】The higher-rank version of CE-300I, available to use thanks to Otsu-Yasui Lab. 4'' wafers. Gas: Cl2, BCL3, Ar, O2, CF4, CHF3, SF6, C3F8.
汎用平行平板RIE装置
Reactive Ion Etching system
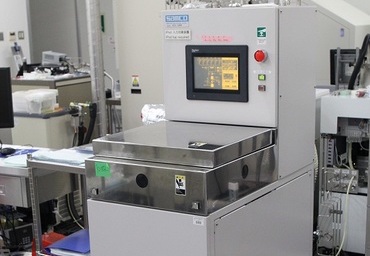
【English】Reactive Ion Etching system
【別名】
【型式番号】SAMCO RIE-10NR装置
【apparatus ID】150
【機器ID】F-UT-137
【機能】8”装置。SF6, CHF3, CF4, Ar, O2によるエッチングが可能。ヘリウム背圧冷却が不要
【Alias】
【Model Number】SAMCO RIE-10NR
【Apparatus ID】150
【Equipment ID】F-UT-137
【Specifications】Up to 8'' wafers. SF6, CHF3, CF4, Ar, O2. No cooling down by He.
ドライエッチング(その他)
Dry Etching (Others)
その他のドライエッチングでは、例えば高周波誘導結合プラズマ(Inductively Coupled Plasma: ICP)活用のエッチングや分析技術、二周波励起プラズマエッチング装置、ラジカル計測付多目的プラズマプロセス装置などがある。
Other dry etching includes, for example, etching and analysis techniques utilizing Inductively Coupled Plasma (ICP), dual-frequency plasma etch systems, and multi-purpose plasma process systems with radical measurement.
汎用NLDエッチング装置
General Purpose NLD Etching System

【English】Neutral Loop Discharge (NLD) plasm dry etching system
【別名】NLD ULVAC NLD-5700Si
【型式番号】NLD-5700Si
【apparatus ID】173
【機器ID】F-UT-155
【機能】ガラスの深掘りが可能なニュートラルループディスチャージ(NLD)エッチング装置。当面は技術補助のみ。
【Alias】
【Model Number】NLD ULVAC NLD-5700Si
【Apparatus ID】173
【Equipment ID】F-UT-155
【Specifications】Neutral Loop Discharge (NLD) etching system capable of digging deep into glass. For the time being, only technical assistance is available.
ウエット/ガスエッチング、洗浄
Wet/Gas Etching, Cleaning
エッチング液を満たした容器内でエッチングするウエットエッチングは、大量の基板の一括処理可能、装置や薬品の価格が安い、ドライエッチングに比べてエッチングされる母材に与える損傷が少ないなどの利点がある。欠点としては、エッチング深さが深いとエッチマスクの真下にも腐食が進む(アンダーカット)があるため、精度の高い微細加工が難しい。犠牲層エッチングなどには非プラズマの気相エッチング装置が使われる。また、洗浄用には純水製造装置が使われる。
Wet etching, in which etching is performed in a container filled with etching solution, has advantages such as the possibility of batch processing of a large number of substrates, low cost of equipment and chemicals, and less damage to the base material to be etched compared to dry etching. The disadvantage of wet etching is that if the etching depth is too deep, corrosion can occur directly below the etch mask (undercut), making highly precise microfabrication difficult. A non-plasma gas-phase etching system is used for sacrificial layer etching. Also, pure water production equipment is used for cleaning.
クリーンドラフト潤沢超純水付
Draft Chambers with DI water taps

【English】Draft Chambers with DI water taps
【別名】ドラフトチャンバー
【型式番号】
【apparatus ID】106
【機器ID】F-UT-106
【機能】化学作業を行うためのいわゆる「ドラフトチャンバー」を用意しています。クリーンルーム1にはアルカリ2台、酸1台、有機1台、クリーンルーム2にはアルカリ2台、酸2台、有機1台あり、利用できます。全てに潤沢な超純水を取れる口があり、一度使うと湯水のごとく超純水が使えることに誰もが驚きます。窒素ガンも用意してあり、洗ったサンプルを窒素ブローで乾かすこともできます。
【Alias】
【Model Number】
【Apparatus ID】106
【Equipment ID】F-UT-106
【Specifications】For work with chemicals.In CR1: alkali draft x2, acid draft x1, organics draft x1. In CR2: alkali draft x2, acid draft x2, organics draft x1. Taps with abundant ultrapure water. N2 gun for sample drying.
気相フッ酸エッチング装置
Vapor Phase HF Etcher
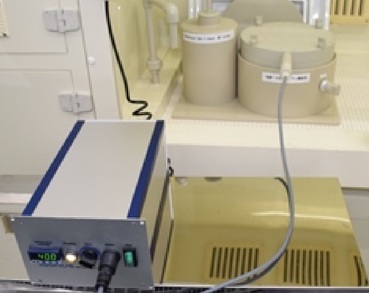
【English】Vapor Phase HF Etcher
【別名】
【型式番号】IDONUS 8インチ装置 Vapor HF専用
【apparatus ID】137
【機器ID】F-UT-124
【機能】気相フッ化水素(HF水溶液を蒸発)によって、選択的にシリコン酸化膜をエッチングし、可動構造体をリリースするための装置です。独自構造によって、フッ酸に直接触れることなく、安全に利用することができます。静電チャックによって、任意形状の基板をチャック下エッチングのほか、4、6、8インチの丸ウエーハは機械的クランプを行えます。
【Alias】
【Model Number】HF vapor Idonus HF VPE-150
【Apparatus ID】137
【Equipment ID】F-UT-124
【Specifications】Release of movable structures thanks to the SiO2 etching by vapor phase HF. The specific machine design enable safe use, without direct contact with HF. Electrostatic chuck available for sample size lower than 4''. Mechanical chuck available for 4'', 6'' and 8'' wafers.
集束イオンビーム加工
Focused Ion Beam Processing
集束イオンビーム(Focused Ion Beam: FIB)加工装置は、集束ガリウム(Ga)イオンビームを当てて試料表面の原子をはじきとばすこと(スパッタリング)によって試料を削る装置である。集束イオンビームは数100nmから数nmまで絞ることができるので、ナノ領域での加工が可能である。イオンビームの照射時に飛び出してくる2次電子を測定することにより試料表面の様子を観測するSIM(走査イオン顕微鏡)の機能も持っている。
Focused ion beam (FIB) processing equipment is a device for shaving a sample by applying a focused gallium (Ga) ion beam to repel (sputter) the atoms on the sample surface. Since the focused ion beam can be narrowed down from several hundred nm to several nm, processing in the nano range is possible. It also has the function of a scanning ion microscope (SIM), which observes the surface of a sample by measuring the secondary electrons ejected during ion beam irradiation.
集積回路パターン微細加工(FIB)装置
FIB for LSI Repair

【English】FIB for LSI Repair
【別名】LSI配線修正FIB(V400ACE)
【型式番号】FEI V400ACE
【apparatus ID】147
【機器ID】F-UT-133
【機能】LSI配線を効率的に修正するための装置です。DCG P2Xを置き換えました。
ガスを利用した金属配線カット、絶縁膜堆積、金属配線堆積が可能。
大規模集積回路(VLSI)の配線修正を最も得意とする装置です。
それ以外の利用は東大拠点では微細構造解析で公開しているXvision 200TBの利用がお勧めです。(案内します)
【Alias】
【Model Number】FEI V400ACE
【Apparatus ID】147
【Equipment ID】F-UT-133
【Specifications】Efficient correction of VLSI wiring. Cutting metallic lines using gas, deposition of insulating film or metal. For other type of FIB use, Xvision 200TB belonging to the characterization platform is recommended.
レーザ加工
Laser Processing
レーザ加工は、レーザ光を極めて小さな面積に集光させることにより、大きなエネルギ密度を発生させ、これにより、材料を加熱、溶融もしくは蒸発させるものである。この原理で、鉄、非鉄、セラミック、プラスチックス、木材、布、紙、複合材などほとんどの種類の材料を対象に、自由曲線切断、穴あけ、溶接、表面処理、微細加工などの多岐にわたる加工を行うことができる。
Laser processing generates a large energy density by focusing a laser beam on an extremely small area, which heats, melts or vaporizes the material. With this principle, a wide variety of processes such as free-form cutting, drilling, welding, surface treatment, and microfabrication can be performed on most types of materials, including ferrous, nonferrous, ceramic, plastic, wood, fabric, paper, and composite materials.
高出力NCレーザーカッター
Laser NC process machines

【English】Laser NC process machines
【別名】
【型式番号】Laser Cutter HGTECH HGCF0606
【apparatus ID】177
【機器ID】F-UT-154
【機能】
【Alias】
【Model Number】Laser Cutter HGTECH HGCF0606
【Apparatus ID】177
【Equipment ID】F-UT-154
【Specifications】
エキシマ手動レーザーカッター
Ecimer manual laser cutter

【English】Ecimer manual laser cutter
【別名】Laser Cutter Manual Excimer
【型式番号】浜松ホトニクス L7270MH L7270MH
【apparatus ID】191
【機器ID】F-UT-163
【機能】266nmのレーザー光により指定した点の薄膜(ポリイミド等)を除去できる。
【Alias】Laser Cutter Manual Excimer
【Model Number】Laser Cutter HGTECH HGCF0606
【Apparatus ID】191
【Equipment ID】F-UT-163
【Specifications】The 266nm laser beam can be used to remove the thin film of polyimide and other specified points.